三星加速研发存储器和逻辑芯片集成芯片
编辑:Helan 发布:2015-12-07 11:26三星电子(Samsung Electronics)将以直通硅穿孔(TSV)技术为基础,加速研发将存储器和逻辑芯片集成唯一的集成芯片解决方案。三星将把结合CPU、存储器和通讯等的集成芯片,发展为新业务。
据Digital Times报导,三星将以TSV技术、PoP封装、自主研发系统芯片设计技术等为基础,加强多元集成芯片解决方案,这是三星2013年正式自主研发AP时就着手进行的企划。高性能DRAM、高带宽存储器(HBM)、NAND Flash等存储器产品和AP直接连接,可提升性能和用电效率。
TSV技术是在不到一般纸张厚度一半的DDR4 DRAM芯片上,穿透数百个微细孔洞,填充导电物质,形成贯通芯片的电极,连接上下芯片的技术。利用TSV技术制造的产品,在各个方面的性能都比线装产品表现优越。
三星内部人员表示,TSV技术可谓融合逻辑芯片和存储器,提供新半导体解决方案的滩头堡。要实现半导体单芯片化,一般会使用TSV、PoP、Fan Out等技术。目前三星已实现单芯片解决方案,并确保大部分相关核心技术。
其中TSV和PoP技术较接近完成阶段。三星自2014年起量产的穿戴式设备用ePoP是最具代表性的案例。ePoP结合DRAM、NAND Flash和控制器,并堆叠在AP上。
三星推动的集成芯片,比起移动片大厂高通(Qualcomm)生产的结合AP和调制解调器芯片的集成芯片范围更广。高通的通讯数据技术拥有优势,集成AP、数据芯片、图形处理器(GPU)的Snapdragon系列产品,在移动设备市场上掌握主导权。
惟高通并未尝试与存储器的集成。2015年英特尔(Intel)推出的3D XPoint技术,集成CPU和存储器,但仍局限在服务器和PC等设备。目前在移动设备市场上,还没有企业同时经营AP、存储器、数据芯片事业,且拥有稳定的单芯片解决方案核心技术3D FinFET制程的企业也只有三星。
韩国业界认为,若三星可稳定集成逻辑芯片和存储器芯片的单芯片解决方案,可望在陷入成长停滞的存储器市场上,推动新一波成长。单芯片化、高效能化,将是主导物联网(IoT)市场的必备武器。




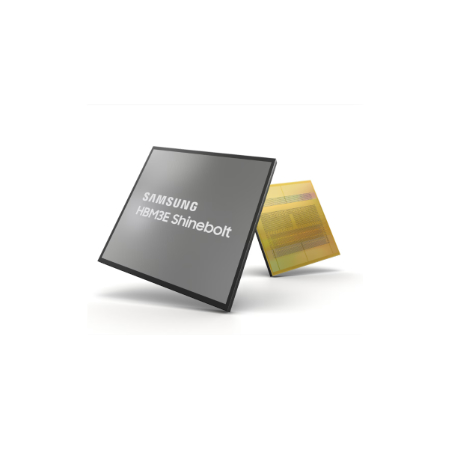













.jpg)



